制造工艺
制造工艺流程
产品信息
我公司拥有从单晶生长到镜面加工的一体化生产线。在直拉法 (CZ)长晶工序中,进行单晶的生长、切割以及圆筒加工。在 刻蚀片(CW) 工序中,将经过圆筒加工的单晶锭切割成晶圆片,并通过研磨和化学处理来提高表面的平坦度。在抛光片(PW) 工序中,经过三阶段的研磨工艺,使晶圆表面达到镜面效果。特殊加工方面,则可根据客户的需求,进行背面损伤处理等工艺。
特殊加工
可根据客户的要求,对晶圆实施背面损伤处理、氧化膜处理、激光标记处理等多种工艺。
检测
为确保所供产品的品质,我们将实施严格的检测。
硅单晶
单晶生长
我们进行单晶的生长、切割和圆筒加工。
本公司采用 CZ 法(直拉法)进行单晶生长。将高纯度多晶硅与用于调节电阻率的掺杂剂投入石英坩埚中,在约 1420℃ 下熔融。
随后,将硅种晶棒接触熔融硅液的液面,在旋转的同时向上拉引,从而生成与种晶相同晶向的单晶硅锭。


切割与圆筒加工
将单晶硅锭切割成块,并通过研磨外圆表面去除应力变形,使其达到规定直径。同时,为了明确晶体取向,还会进行定位平面(Orientation Flat)加工或缺口(Notch)加工。其他加工工序也可根据客户需求进行。

原材料检验
从单晶硅锭中切割出样品晶圆,对其缺陷有无及电阻率等进行检测。
刻蚀片
刻蚀片加工
将经过圆筒加工的单晶硅锭在切片工序中加工成晶圆。在倒角工序中对外周进行加工;在研磨工序中对表层进行粗研磨;在蚀刻工序中去除加工应变;在退火工序中则进行氧施主消除(Donor Killer)处理。
切片
将经过圆筒加工的硅锭,使用内圆切割机或线锯切割机切片成晶圆。


倒角
切片后的晶圆外周存在锐角,为了防止后续工序中的崩边(Chipping),以及避免镜面加工后的颗粒产生,对外周进行倒角处理,同时将晶圆加工至最终直径。
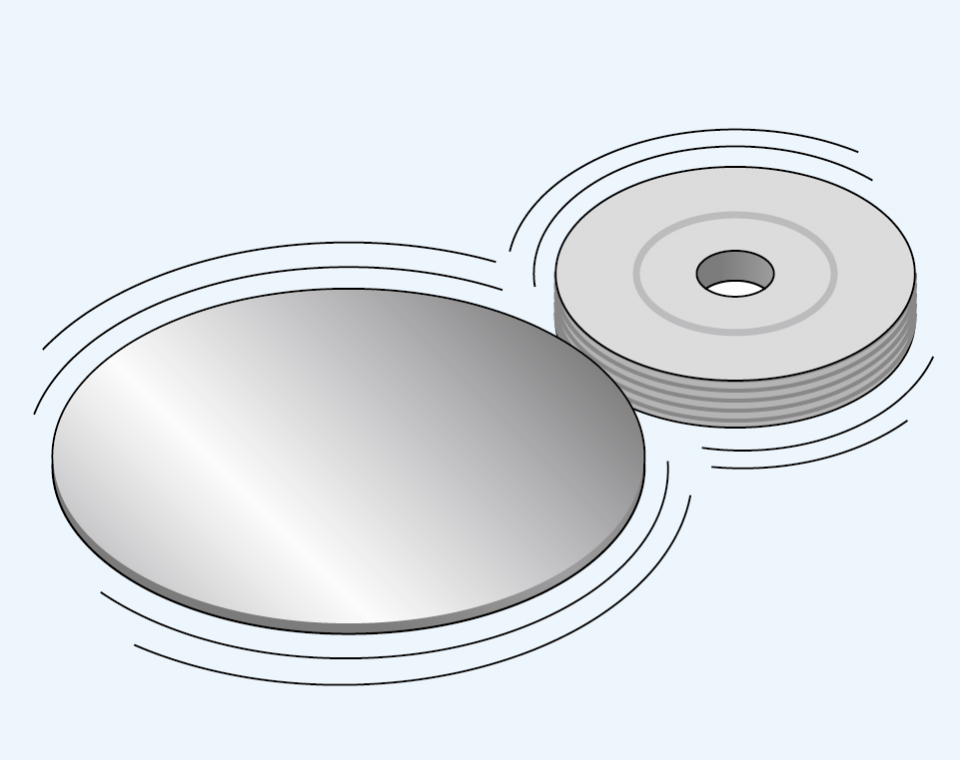
粗磨工序
通过将晶圆夹持在高平坦度的研磨定盘之间施加压力进行研磨,消除晶圆表面的微小凹凸和厚度不均,从而使晶圆厚度均匀。
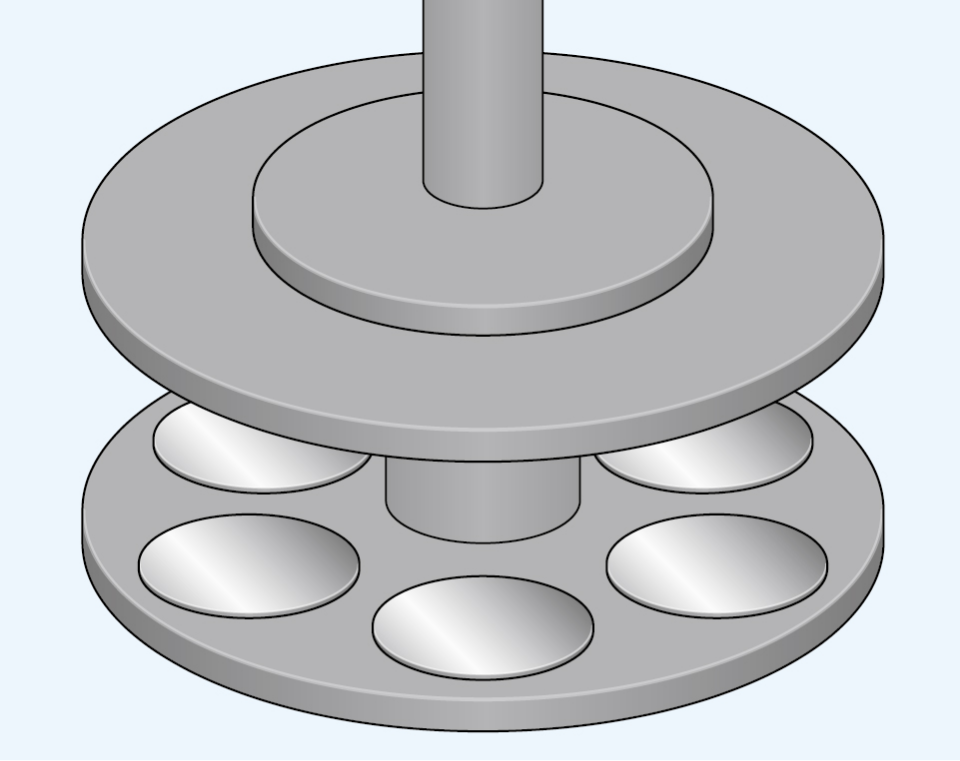
刻蚀
由于切片、倒角、研磨等各工序均为机械加工,晶圆表层残留了大量加工应变。为去除这些应变,需要进行化学药品的蚀刻处理。

退火
单晶在生长过程中会生成氧施主。
为使这些施主失活,将晶圆置入高温炉中进行施主消除处理,从而恢复其电阻率。

刻蚀片检测
通过目视及检测设备进行检验。
通过目视检验对晶圆表面缺陷进行检查,并借助检测设备对平坦度、电阻率、导电类型等项目进行测试,从而在出货前实现最终的质量保证。
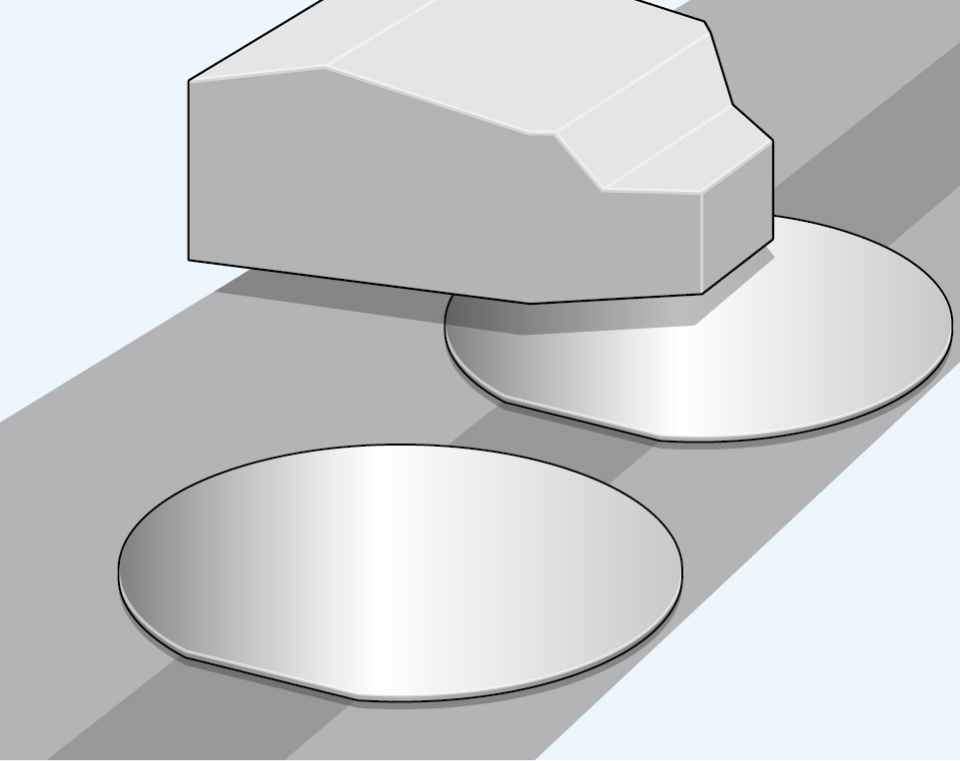
抛光片
载板(Plate)贴合
为了对蚀刻后的晶圆进行镜面研磨,将晶圆的一面贴合并固定在陶瓷板上。
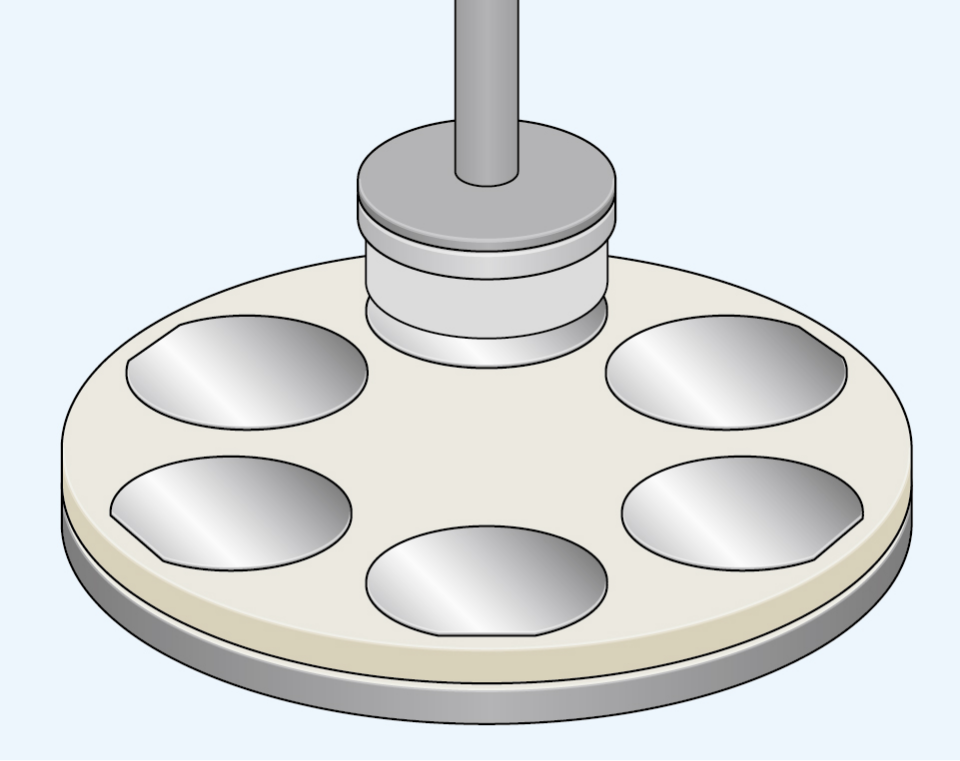
镜面研磨
通过化学机械作用,将晶圆加工成高平坦、无杂质的高质量镜面。
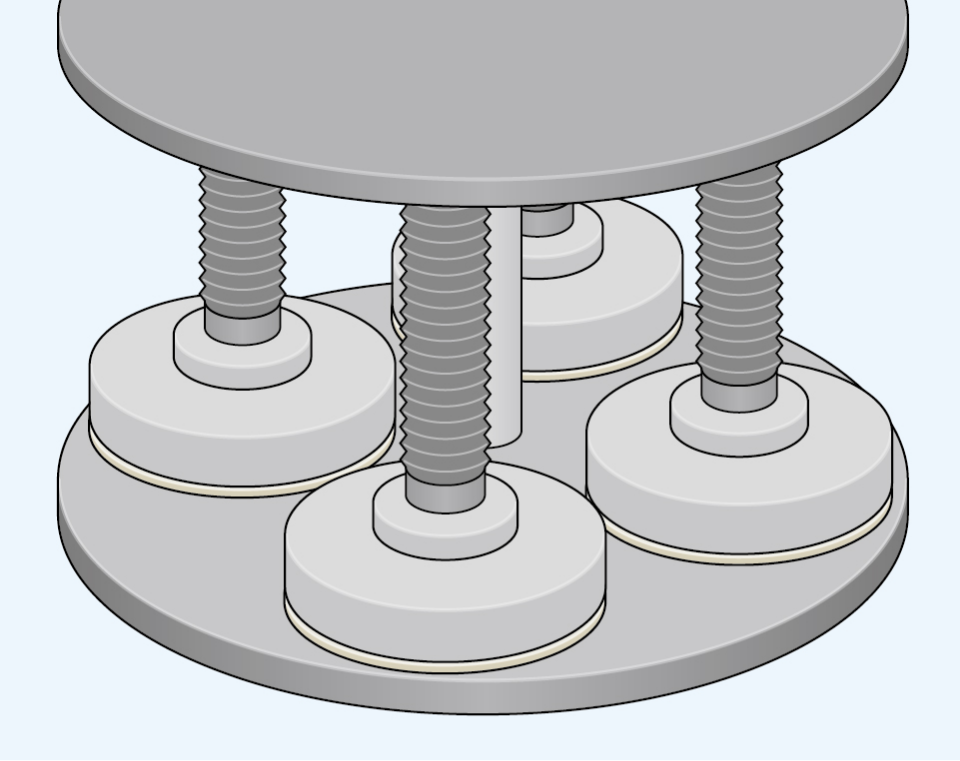
抛光片检测
通过清洗去除颗粒,并进行目视及设备等检验。
通过目视检查晶圆表面缺陷,并利用检测设备对平坦度、电阻率、颗粒、导电类型等进行检测,从而在出货前实现最终的质量保证。