製造工程
製造工程フロー
製品情報
弊社は、単結晶育成から鏡面加工までの一貫生産ラインを持っています。CZ工程では、単結晶の育成・切断・円筒加工まで行います。CW工程では、円筒加工後の単結晶インゴットをウェーハ状にスライスし、研磨加工や化学薬品による加工で表面の平坦度を上げていきます。PW工程では、三段階に分けた研磨を行い、鏡面にします。特殊加工は、お客さまのご要望に応じて裏面ダメージ処理などを行っています。
特殊加工
ご要望に応じてウェーハに、裏面ダメージ処理、酸化膜処理、レーザーマーク処理等の加工も行っています。
検査
提供する製品の品質を保証するために検査を実施します。
単結晶
単結晶育成
単結晶の育成・切断・円筒加工を行います。
弊社では、CZ法での単結晶育成を行っています。高純度のポリシリコンと電気抵抗率調整用のドーパントを石英ルツボに投入し、約1420℃で融解します。
そして、種結晶シリコン棒をシリコン融液の液面につけ、回転させながら引き上げることで種結晶と同じ結晶軸の単結晶インゴットを造ります。


切断・円筒加工
単結晶インゴットをブロックに切断し、外周面を研削することで一定の直径にします。また、結晶方位がわかるように、オリエンテーションフラット加工やノッチ加工を行っています。その他の加工もお客さまのご要望に合わせて行っています。

素材検査
単結晶インゴットからサンプルウェーハを切り出し、欠陥の有無や抵抗率等について検査します。
エッチドウェーハ
エッチドウェーハ加工
筒加工したインゴットをスライス工程でウェーハ状に加工します。面取り工程で外周部を加工します。ラッピング工程で表層部を粗研磨します。エッチング工程で加工歪みを除去します。アニール工程では酸素ドナー消去(ドナーキラー)を行います。
スライス
円筒加工したインゴットを内周刃切断機またはワイヤーソー切断機でウェーハ状にスライスします。


面取り
スライスしたウェーハの外周部は角が立っており、以降の工程でのチッピングの防止や、鏡面加工後のパーティクルの発生を防止するために外周部の面取りを行い、同時にウェーハの最終的な直径へと加工します。
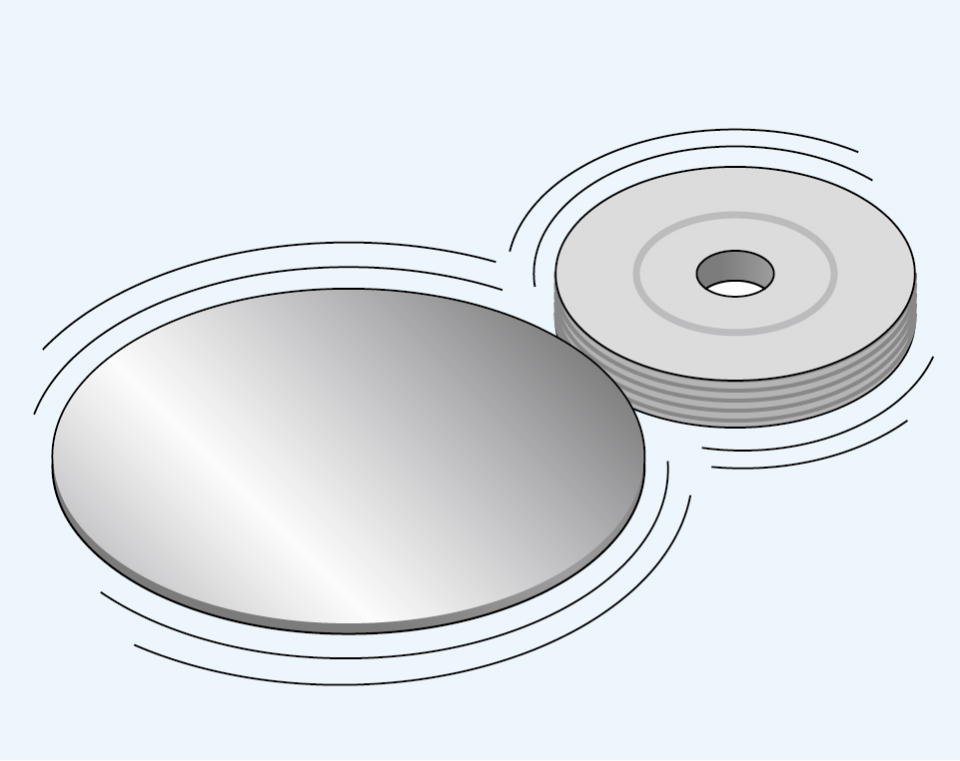
ラッピング
ウェーハ表面にあるミクロな凹凸やウェーハ厚さのバラツキを高平坦度の定盤にウェーハを挟み込み、圧力をかけ研磨することでウェーハの厚さを整えます。
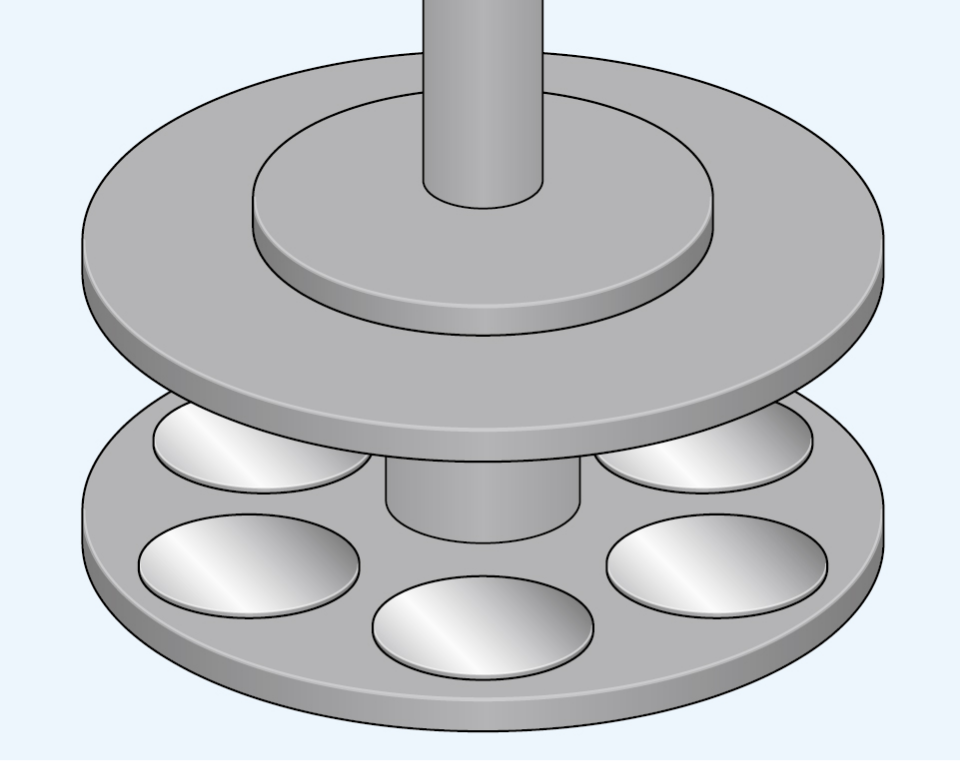
エッチング
スライス、面取り、ラップの各工程までは機械的な加工を施すため、ウェーハの表層部には加工歪みが多く残留しています。これを除去するために化学薬品によるエッチング処理を行います。

アニール
単結晶には育成中に生成した酸素ドナーが存在します。
ドナーを不活性化するため、ウェーハを高温炉に投入しドナー消去を行うことで抵抗率の回復を行います。

CW検査
目視・装置等による検査を行います。
目視検査によるウェーハの表面不良検査、検査装置による平坦度、抵抗率、導電型などの検査を実施することで、出荷前の最終的な品質保証を行います。
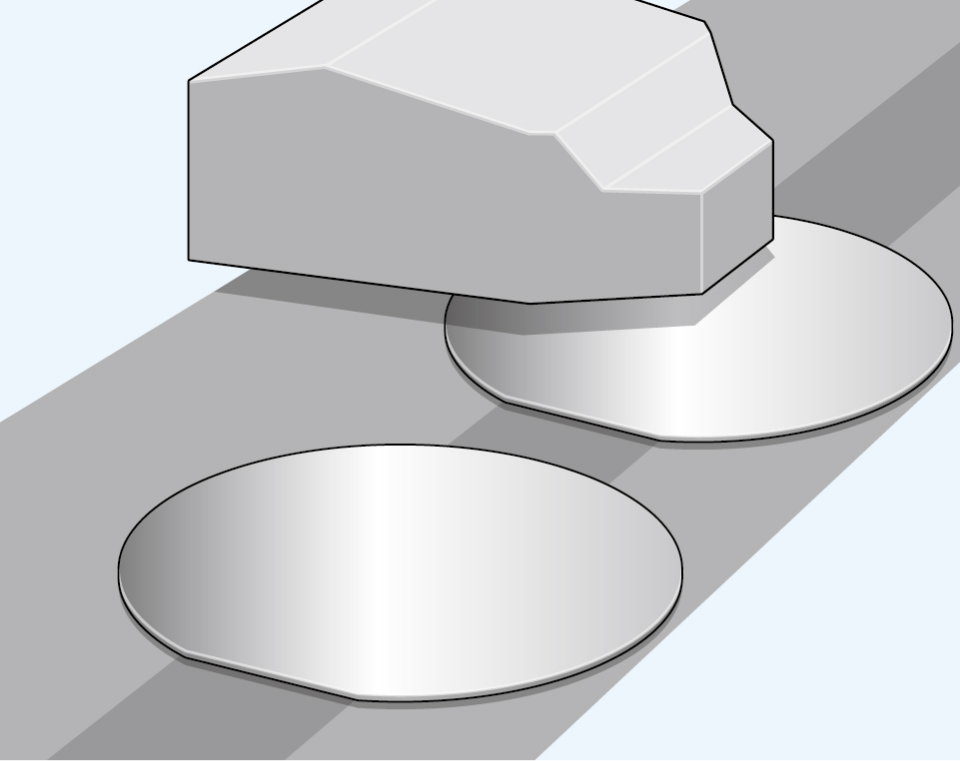
ポリッシュドウェーハ
プレート接着
エッチング後のウェーハを鏡面研磨するために、セラミックプレートにウェーハの片面を接着し固定します。
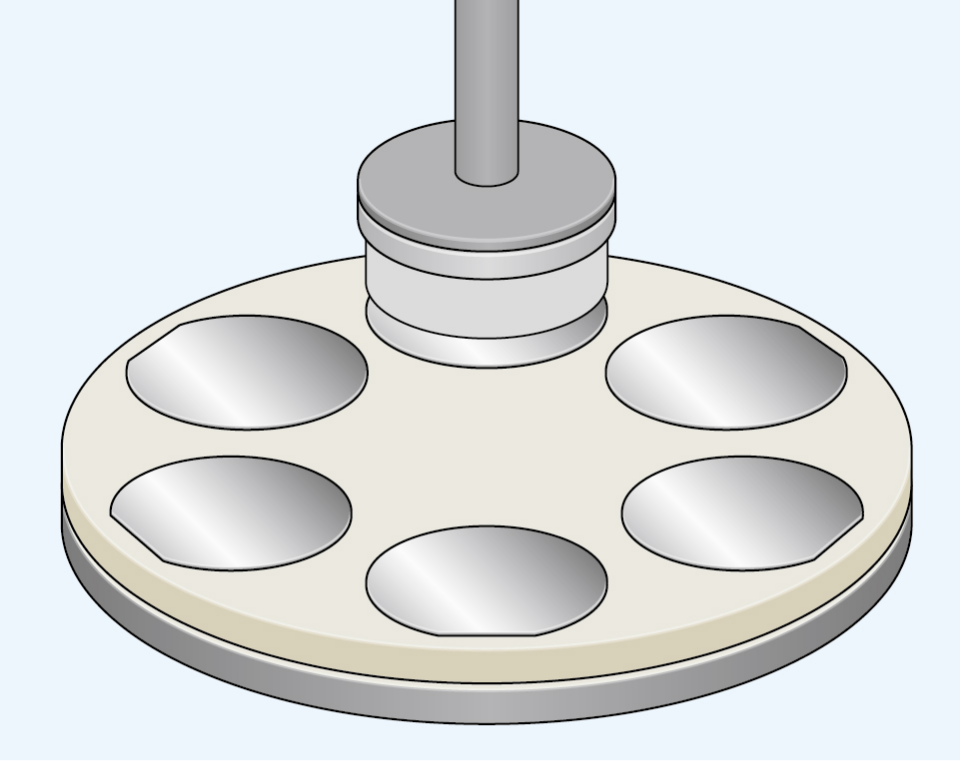
鏡面研磨
ケミカルメカニカル作用により高平坦で不純物の無い高品質な鏡面に仕上げます。
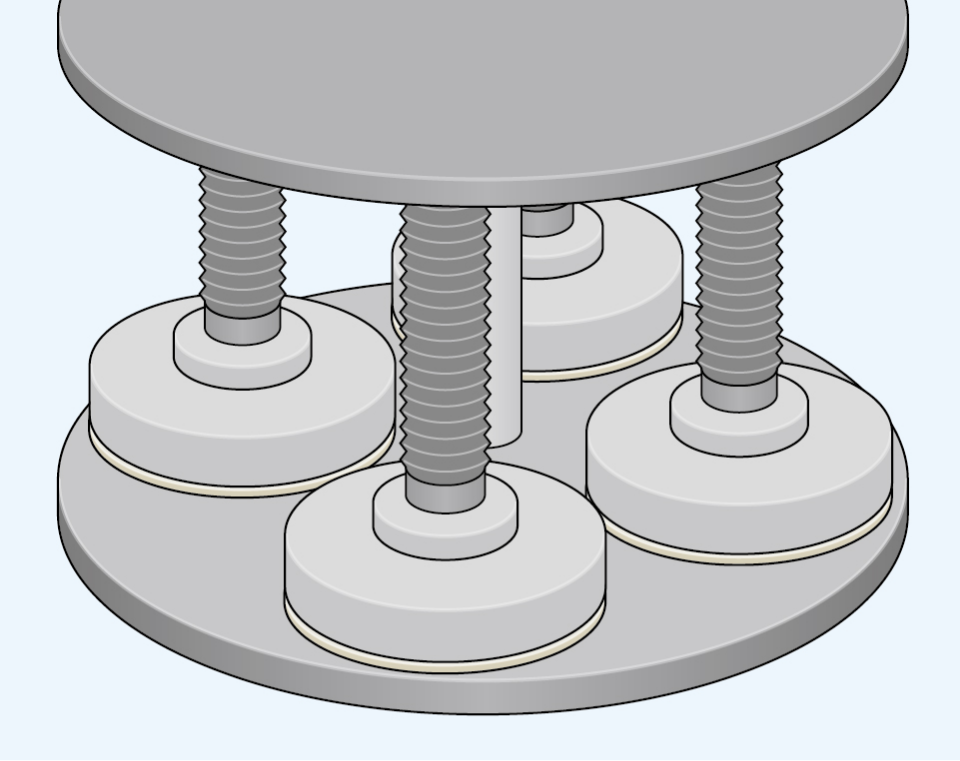
PW検査
洗浄によるパーティクル除去ならびに、目視・装置等による検査を行います。
目視検査によるウェーハの表面不良検査、検査装置による平坦度、抵抗率、パーティクル、導電型などの検査を実施することで、出荷前の最終的な品質保証を行います。